當大家還在為摩爾定律放緩而焦慮時,半導體產業突然迎來了一位“新玩家”——玻璃。從英特爾、三星到英偉達,從京東方到康寧,一眾科技巨頭紛紛盯上了這個看似普通的材料,希望用玻璃基板打破芯片性能提升的瓶頸。這場圍繞玻璃基板的競逐,正悄然改寫半導體產業的競爭格局。
芯片性能遇瓶頸,封裝成破局關鍵
我們都知道,芯片的誕生要經過設計、制造和封裝測試三大環節。就像蓋房子,設計是畫圖紙,制造是打地基砌墻,封裝則是給房子做裝修和加固。如今,隨著人工智能、5G等技術的爆發,大家對芯片性能的需求越來越高,但作為芯片發展“圣經”的摩爾定律,已經快走到頭了,晶體管密度再想翻倍,面臨著物理規律的重重阻礙。
這時候,行業把目光投向了封裝環節。簡單說,先進封裝就是通過更精巧的方式,把多個芯片“打包”在一起,讓它們協同工作,從而在不縮小晶體管的情況下提升整體性能。比如現在熱門的2.5D/3D封裝技術,就像把平房改成立體樓,在有限空間里塞下更多功能。
但先進封裝可不是簡單堆疊,它對封裝材料提出了嚴苛要求:既要保護芯片,又要控制尺寸,還要散熱好、數據傳輸快,成本還得可控。長期以來,行業一直用有機材料做基板,但有機材料和芯片的熱膨脹系數差太多。芯片工作時會發熱,有機材料基板熱脹冷縮的幅度和芯片不匹配,很容易變形甚至斷裂,成了制約性能的短板。
玻璃基板成新寵?
在顯示技術、半導體封裝等領域,玻璃基板相比有機基板具有多方面顯著優勢,這些優勢使其在高端應用場景中逐漸成為新的選擇。
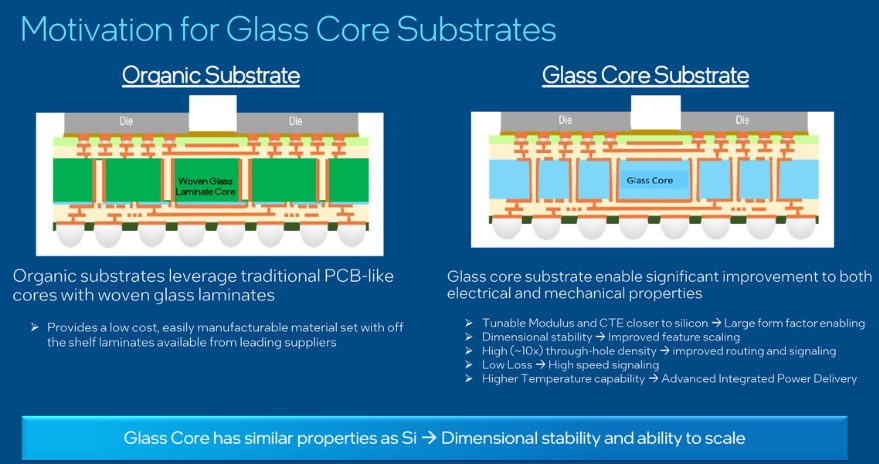
玻璃基板對比有機基板 來源:英特爾
穩定性超強:玻璃的熱穩定性和機械穩定性遠勝塑料,高溫下也不容易變形,能減少芯片的機械應力,大大延長使用壽命。
平整度絕佳:玻璃表面非常平整,這對芯片封裝中的光刻工藝來說太重要了,能提高聚焦精度,讓封裝質量更上一層樓。
信號傳輸更快:通過玻璃通孔(TGV)技術,可以在玻璃上做出更精細的線路,布線密度更高,線路更薄,信號傳輸時的損耗更小,速度自然更快。
成本有潛力:雖然玻璃基板的前期投入高,但一旦規模化生產,物料成本會比塑料低,長期來看性價比更高。
也正因如此,全球半導體巨頭都動了起來。英特爾、三星、英偉達、AMD等紛紛加碼玻璃基板研究,連蘋果也在和供應商探討應用可能。據Prismark統計數據,到2026年全球IC封裝基板市場規模將達214億美元,而玻璃基板的滲透率可能在3年內達到30%,5年內超過50%,發展速度驚人。
誰在搶這塊“玻璃蛋糕”?
玻璃基板的火爆,讓整個產業鏈都沸騰了,目前,至少三類玩家正在激烈競逐。
傳統玻璃巨頭:像德國肖特、美國康寧這些做特種玻璃的老牌企業,早就積累了深厚的技術功底。康寧在玻璃通孔、高密度布線等關鍵技術上研究多年,肖特也表示要把玻璃性能發揮到極致,一旦克服量產難題就能快速落地。它們的優勢在于對玻璃材料的理解深刻,能根據芯片需求定制不同性能的玻璃。
半導體產業鏈企業:英特爾、三星等芯片大廠本身就有封裝需求,它們入局既能推動技術落地,也能保障自己的供應鏈安全。比如三星,已經組建了跨部門的研發團隊,計劃2026年大規模生產玻璃基板。
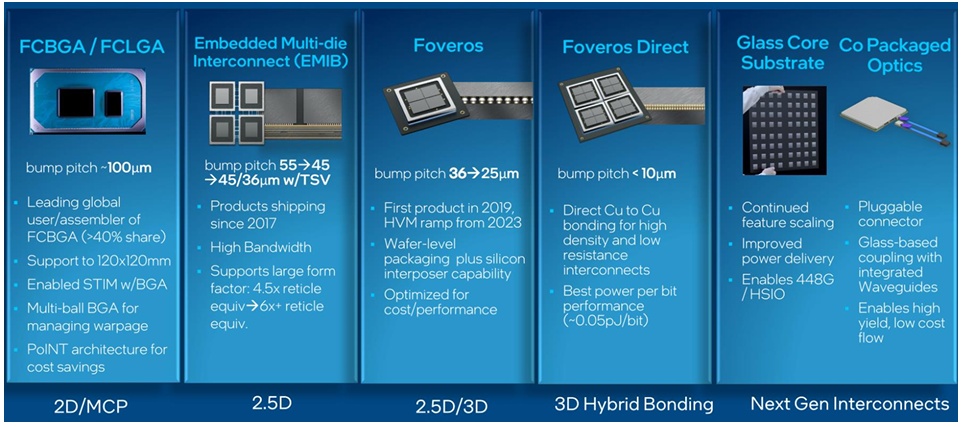
先進封裝迭代圖 來源:英特爾
顯示面板企業:京東方、三星顯示、群創光電這些做屏幕的企業,其液晶面板的核心材料就是玻璃基板,這些企業研究了幾十年玻璃,對玻璃的特性、加工工藝(比如薄化、刻蝕、鍍膜)非常熟悉,它們的大規模生產能力,能快速降低玻璃基板的成本。
前景光明,挑戰也不小
雖然玻璃基板前景廣闊,但要真正實現大規模商用,還有不少坎要過。
首先是技術難關。比如玻璃通孔技術(TGV),要在玻璃上打出細密均勻的小孔,還要精準填充導電材料,難度不小;另外,玻璃比塑料脆,加工過程中容易碎裂,如何提高良率是個大問題。
其次是人才和經驗壁壘。顯示企業雖然懂玻璃,但半導體封裝和面板封裝差異很大,對精度、可靠性的要求更高。中科院院士歐陽鐘燦就指出,這些企業需要培養半導體封裝領域的專業人才,還要適應半導體行業更嚴格的認證體系,這都需要時間。
不過,隨著各大巨頭的投入,技術成熟速度在加快,成本也會逐步下降。可以預見,未來幾年,玻璃基板將在先進封裝領域快速普及,從高端芯片向更多領域滲透。
參考來源:
中國電子報《玻璃在半導體封裝領域初試牛刀——顯示玻璃系列報道之三》
廣發證券《玻璃基板從零到一,TGV為關鍵工藝》
陳怡靜.封接玻璃作用機理和應用研究進展
(中國粉體網編輯整理/月明)
注:圖片非商業用途,存在侵權告知刪除!


















