中國粉體網訊 在半導體產業持續向高性能、小型化、低成本的方向迅猛發展的當下,先進封裝技術已然成為突破摩爾定律瓶頸、推動行業前行的核心驅動力。其中,TGV(玻璃通孔)技術與TSV(硅基通孔)技術作為實現芯片間三維互連的關鍵方案,正展開激烈的技術競賽,引發了整個半導體行業的高度關注。
核心技術原理:相似路徑,不同材質
TSV技術的核心目標是達成芯片內部不同層面間的電氣連接。其具體操作流程為,在硅晶圓上精準蝕刻出垂直貫通的微小通孔,隨后在這些通孔中填充銅、鎢等導電材料。
TGV技術則是在玻璃基板上構建垂直貫通的微小通孔,并填充導電材料來實現電氣連接。在玻璃材料的選擇上,通常會選用具有較低熱膨脹系數和較高介電性能的高品質硼硅玻璃或石英玻璃。
性能特點:各有千秋,TGV高頻優勢凸顯
信號完整性:在信號完整性方面,TSV與TGV各具特色。TSV技術依托硅材料的特性,在精確工藝控制下,能夠實現高速、低噪聲和低失真的信號傳輸。然而,隨著芯片集成度向5nm以下制程不斷逼近,硅材料中自由載流子引發的信號干擾問題愈發嚴重。特別是在6GHz以上的高頻場景下,信號衰減率大大增加,這嚴重限制了其在5G基站、數據中心等對高頻性能要求極高的領域的進一步應用。TGV技術則與之形成鮮明對比,玻璃材料的介電常數低至3.8,僅為硅材料的1/3,損耗因子低于0.001,較硅材料低2-3個數量級,能夠更好地滿足信號高速、穩定傳輸的需求。
機械性能:在機械性能方面,硅材料硬度和強度較高,但受到較大外力沖擊時,容易發生脆性斷裂。玻璃材料相對較脆,但其機械穩定性較強,特別是在厚度小于100μm時,翹曲程度極小。在對芯片尺寸和厚度要求較高的可穿戴設備和移動終端等應用中,TGV技術所采用的玻璃基板能夠在保證機械性能的同時,實現更輕薄的設計,滿足產品小型化、輕量化的發展趨勢。
應用領域:市場分化,各據優勢賽道
TSV應用領域:憑借在提高芯片互連密度和降低信號傳輸延遲方面的顯著優勢,TSV技術在高性能芯片領域占據了重要地位,以英偉達H100GPU為例,通過TSV技術實現的芯片互連,使其數據處理速度提升了3倍,有力地支撐了AI訓練等高密度計算需求。在存儲器領域,特別是堆疊式動態隨機存取存儲器(DRAM)的制作中,TSV技術能夠實現更高的存儲容量和更快的數據傳輸速度,滿足大數據存儲和快速讀寫的需求。在處理器和圖像傳感器等芯片中,TSV技術的應用也可顯著提升芯片性能,使處理器能夠更快地處理數據,圖像傳感器能夠更快速、準確地捕捉和傳輸圖像信號。
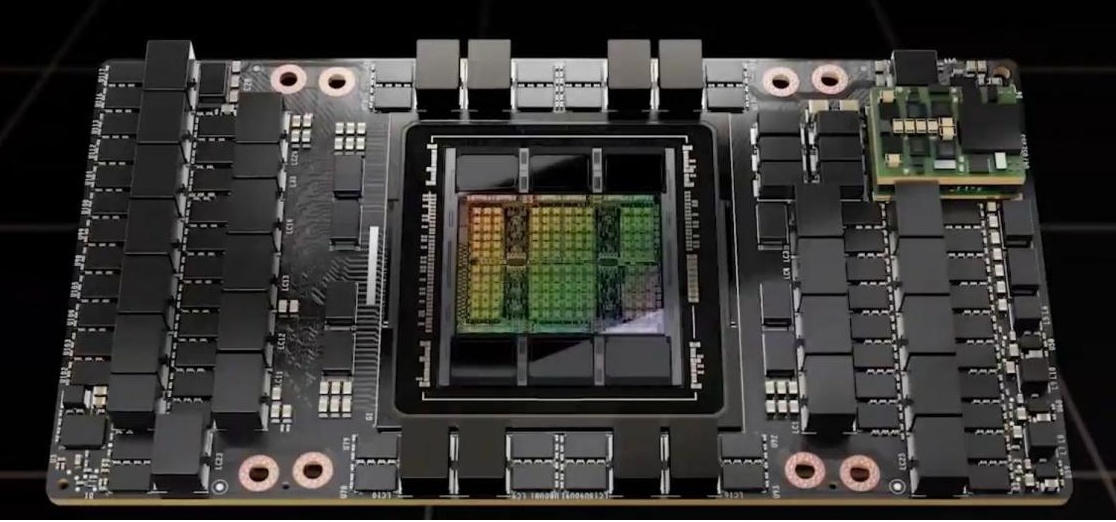
H100GPU核心 來源:英偉達
TGV應用領域:TGV技術憑借其獨特的性能優勢,在多個新興領域展現出巨大的發展潛力。在射頻和微波領域,TGV技術的優良高頻電學特性能夠有效減少信號傳輸過程中的損耗和干擾,提升射頻系統的性能;在微機電系統(MEMS)中,TGV技術可用于實現MEMS器件與其他芯片之間的高效互連,推動MEMS技術在傳感器、執行器等領域的應用發展;在先進封裝領域,TGV技術作為一種新興的縱向互連技術,有望實現芯片之間距離最短、間距最小的互聯,為系統級封裝(SiP)和三維集成提供更優的解決方案,推動電子產品向小型化、高性能化方向發展。
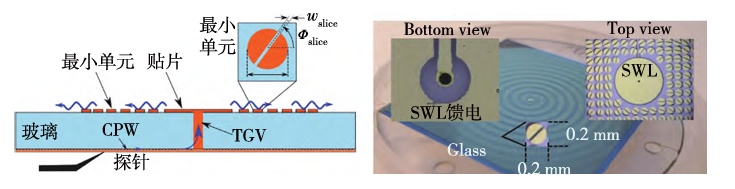
基于TGV技術的全息天線 來源:Galler.High-gain millimeter-wave holographic antenna in package using glass technology
技術瓶頸與突破:挑戰并存,創新驅動前行
TSV技術瓶頸:盡管TSV技術應用廣泛,但也面臨著諸多挑戰。其中,成本問題尤為突出,在HBM(高帶寬內存)封裝中,TSV成本占比接近30%,這在很大程度上制約了其大規模應用,隨著芯片集成度的不斷提高,硅材料在高頻應用中的信號完整性問題也日益凸顯,成為阻礙其進一步發展的關鍵因素。
TGV技術瓶頸:TGV技術同樣面臨難題,玻璃深孔加工難度較大,傳統的激光鉆孔法在制作高深寬比通孔時,效率不足硅蝕刻的1/5。玻璃材料相對較脆,在加工過程中容易出現破裂等問題,影響產品良率。
展望:技術競爭推動產業變革
隨著半導體產業競爭的日益激烈,對芯片性能、尺寸和成本的要求不斷提高,TSV技術和TGV技術將持續演進。未來,這兩種技術可能會相互融合、取長補短,共同推動半導體封裝技術向更高水平發展,為電子產品的性能提升和創新提供堅實的技術支撐,重塑全球半導體產業格局。
參考來源:
鐘毅.芯片三維互連技術及異質集成研究進展
郭育華.玻璃通孔的高頻傳輸性能
Galler.High-gain millimeter-wave holographic antenna in package using glass technology
(中國粉體網編輯整理/月明)
注:圖片非商業用途,存在侵權告知刪除!