中國粉體網訊 在去年,玻璃基板作為封裝環節的關鍵材料,仿佛一夜之間火了起來,成為半導體行業的新熱點和新趨勢。
有報道稱英偉達的最新產品GB200采用的先進封裝工藝將使用玻璃基板,同時,英特爾、三星、AMD、蘋果等大廠都表示將導入或探索玻璃基板芯片封裝技術。
為何芯片巨頭都青睞玻璃基板?
封裝基板主要利用材料本身具有的高熱導率,將熱量從芯片 (熱源) 導出,實現與外界環境的熱交換。
在目前的封裝基板材料中,有機基板具有質量輕、可實現復雜電路設計、工藝流程簡單、生產成本低等優點,但有機基板的高溫熱穩定性差,易受高溫影響而變形;陶瓷基板的介電性能穩定,機械性能好,能滿足集成電路的需求,但制造成本較高,且不適用于對輕量化有需求的應用場景。
出于制程工藝的邁進,芯片大廠們認為,陶瓷和有機基板將在未來幾年達到其能力的極限。比如英特爾表示,到本世紀末,半導體行業使用有機材料在硅封裝上擴展晶體管的能力將達到極限。
而如果芯片改用玻璃基板后將大幅提高電路板能承受的溫度,使芯片在更高溫度下工作,并在更長時間內維持最高性能。此外,玻璃基板具有扁平特性,能進行更精確雕刻,使元件間距離更近,增加任何給定尺寸內的電路密度。
玻璃基板在機械和電氣性能方面也很出色,在制造超大型芯片時也不像有機基板那么不理想。這些基板可容納的功率和數據連接數量是當今有機基板的10倍。這對于服務于數據人工智能(AI)和高性能計算(HPC)應用的大型芯片至關重要。所以玻璃基板的發展,對于目前芯片來說有著很重大的意義,至少在工藝發展難度和成本更高的時候,玻璃基板的發展會更現實。
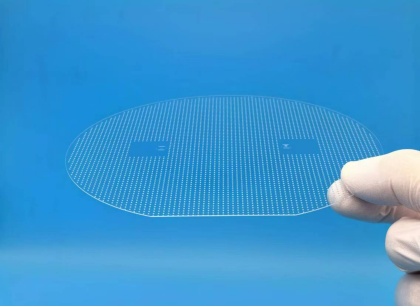
圖片來源:中科島晶
此外,隨著芯片3D封裝技術的發展,硅通孔(TSV)技術和玻璃通孔(TGV)技術相繼得到應用。其中TGV技術全稱為玻璃基微米級巨量互通技術,通過玻璃材料和孔加工技術實現的高品質TGV,可以實現數據中心、5G通信網絡和IoT設備等各種市場的設備小型化,并實現高密度封裝和GHz速度的數據處理,同時由于玻璃基板具有更優的散熱性,有助于降低功耗,其在高算力數據中心服務器等領域有一定應用空間。TGV有望成為下一代半導體封裝基板材料的技術解決方案,在TGV技術中,玻璃基板可提供高密度電氣互連的解決方案。
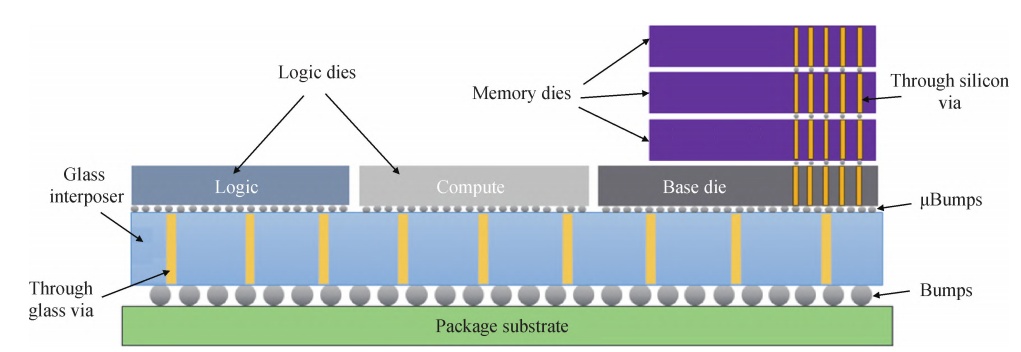
芯片3D封裝結構示意圖
目前業內的共識是,使用玻璃基板已經成為先進封裝的一個趨勢,但目前還存在一些技術和成本上的挑戰。接下來,芯片企業與玻璃處理設備以及材料供應商需通過密切合作,建立一個可行的商業生產生態系統,加速推進該技術的商業化應用。
為此,中國粉體網特建“玻璃基板TGV技術交流群”,以期加強玻璃基板產業上下游交流,共同探討學習產業技術,共同促進行業發展。

(中國粉體網/山川)
注:圖片非商業用途,存在侵權告知刪除


















