中國粉體網(wǎng)訊 化學(xué)機械拋光(CMP)借助于拋光液中化學(xué)試劑的化學(xué)腐蝕和納米磨粒的機械磨削雙重耦合作用,可以在原子水平上實現(xiàn)材料的去除,可以在0.35μm及其以下尺寸器件上同時實現(xiàn)局部和全局平坦化,被廣泛應(yīng)用于光學(xué)元件、計算機硬盤、微機電系統(tǒng)、集成電路等領(lǐng)域。
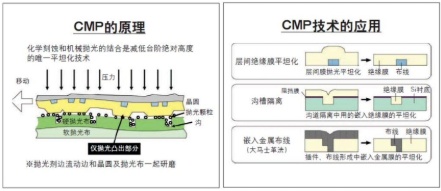
CMP制程原理圖
在CMP過程中,拋光液(漿料)對拋光效果起到至關(guān)重要的影響,其主要作用是在晶片表面產(chǎn)生化學(xué)反應(yīng),所形成的反應(yīng)物再由磨料的機械摩擦作用去除。在化學(xué)成膜與機械去膜的交替過程中,通過化學(xué)與機械的共同作用從工件表面去除極薄的一層材料,最終實現(xiàn)晶片的超精密表面加工。CMP拋光液一般由去離子水、磨料以及pH調(diào)節(jié)劑、氧化劑、分散劑和表面活性劑等化學(xué)助劑等組成,有利于提升CMP的綜合效果。
浙江博來納潤電子材料有限公司(簡稱“博來納潤”)專注于為泛半導(dǎo)體行業(yè)平坦化材料提供整體解決方案,致力于電子級納米氧化硅磨料、泛半導(dǎo)體用CMP拋光液、拋光墊等產(chǎn)品的技術(shù)研發(fā)和產(chǎn)業(yè)化,為半導(dǎo)體襯底等材料的納米級平坦化提供工藝材料整體解決方案。
公司主要產(chǎn)品包括硅溶膠、拋光液、拋光墊,應(yīng)用領(lǐng)域涵蓋碳化硅襯底CMP制程、硅襯底CMP制程、集成電路CMP制程、其他泛半導(dǎo)體材料CMP制程。
公司本次推出多款拋光液,具備不同性能特點。

來源:博來納潤
該產(chǎn)品線覆蓋6寸、8寸、12寸硅片的拋光需求,產(chǎn)品具備優(yōu)異的去除速率、循環(huán)穩(wěn)定性、儲存穩(wěn)定性和拋光后低金屬離子殘留等優(yōu)勢;并且拋光液中最重要的成分——硅溶膠研磨顆粒,全部使用自產(chǎn)硅溶膠,既能保障供應(yīng)鏈的安全性,又能使產(chǎn)品在市場推廣中具備成本優(yōu)勢。
參考來源:
1.中國粉體網(wǎng)、博來納潤
2.曹威等,化學(xué)機械拋光墊的研究進(jìn)展
3.嚴(yán)嘉勝等,硅晶片化學(xué)機械拋光液的研究進(jìn)展
(中國粉體網(wǎng)編輯整理/山林)
注:圖片非商業(yè)用途,存在侵權(quán)告知刪除!

















